装置紹介 - EM -
透射电镜TEM

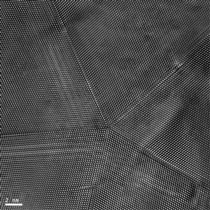
超高分辨率分析电子显微镜(TEM。,JEM-ARM 200F)是在照射系统中配备球面像差校正器的电子显微镜,具有透射(TEM)和扫描透射(STEM)功能。该设备是一种使用肖特基发射的电子枪,其阴极使用ZrO / W发射器,比热电子枪具有更高的亮度和更小的电子源。由于它被加热到了1800K的高温,因此它具有比电场发射电子枪更高的电流稳定性,并且可以获得大的探针电流。此外,即使操作压力高达两位数,也可以使用电子枪的真空,因此维护简便,可以有效地使用高分辨率的观察和分析功能。附带的球面像差校正器(Cs收集器)通过产生负球面像差系数来抵消磁场轴对称的聚光透镜的正球面像差系数,并且通过此功能,可以获得更小,强度更高的探头。这样可以进行更高分辨率的元素分析。通过检测已经穿过薄膜样品的电子来获得STEM图像,并且可以获得散射吸收对比,衍射对比,相位对比等。
聚焦离子束装置FIB

聚焦离子束装置(FIB)是用直径为几十nm的Ga离子束照射样品并将其加工成任意形状的装置。通过获取二次离子图像,可以在观察放大图像的同时进行挖掘,这对于作为观察特定部分的横截面的样品制备设备很有用。尤其是当用透射电子显微镜对样品进行薄化观察时,其优点在于可以仅对对感兴趣的部分进行精确处理。另外,它配备有微采样系统,并且可以使用极小的探针从散装样品中提取几µm样品,并将其结合到TEM栅格等上。
生物系透過型電子顕微鏡 3D-TEM


LaB6配备有LaB6电子枪的200 kV透射电子显微镜(JEM-2100)既可以进行高分辨率观察又可以实现高对比度,并且适合于观察生物样品。可以使用CCD相机将TEM图像捕获为数字数据。使用高倾斜支架可以将样品倾斜到±80°,并且可以通过TEM断层扫描系统自动获取连续的倾斜图像。可以通过PC进行样品的3D重建和3D结构的可视化。
场发射分析扫描电子显微镜FE-SEM + EDS

JEOL的扫描电子显微镜(SEM)JSM-F100可以将电子束加速电压设置为10 V至30 kV,并且可以处理易受热损坏和绝缘物的样品。它也可以选择在比通常更低的真空度下进行观察。此外,除了增加电子束的高亮度外,EDS检测的阻止面积也有所增加,因此元素分析的性能也得到了显着提升。该JSM-F100能在通过二次电子图像进行的视野搜索的同时自动显示视野中的元素,并且可以通过简单的操作在观察和分析之间切换,可以有效地分析样品表面。
X射线微量分析仪EPMA


EPMA(电子探针微分析仪)将LaB6电子枪产生的电子束缩小到几十纳米,将其加速到最大40 kV,并照射在固体样品表面上。可以通过生成的特征X射线的波长识别组成样品的元素来进行定量分析。还可以执行映射测量和线分析以了解元素分布状态。测量元件的范围是从B到U,并配备了8个光谱晶体和4个检测器。本设备的特点是还能进行阴极发光的测量。这对于评估半导体材料(例如金属,矿物和陶瓷)十分有用。
X射线光电子能谱仪


X 射线光电子能谱仪 (XPS) 是一种用于样品表面分析的仪器,涵盖金属、半导体、有机物和陶瓷等多种材料。 可测量大多数元素,也可分析化学键状态。 测量可从样品表面深入到大约 6 纳米的深度,分析区域为 15-700 微米。 该系统还配备了氩簇射枪,可在蚀刻过程中将样品损伤降到最低。 此外,该系统还配备了一个银 X 射线源,可在传统的铝或镁 X 射线源无法观察到的深度对样品信息进行无损测量。
飞行时间二次离子质谱仪TOF-SIMS

TOF-SIMS是一种表面分析仪,可以同时获取高灵敏度的元素和分子。 IONTOF公司的 M6仅能采取1-2 nm深度的非常浅的信息,但可以获取有关固体样品的表面,薄膜和界面的详细信息,因此被广泛用于工业领域和研究应用。而且,通过使用溅射枪进行深度方向分析,可以获得高精度的深度分布。它的应用范围广泛,包括半导体,聚合材料,油漆,涂料,玻璃,纸张,金属,陶瓷,生物材料和制药等方面。